芯片散热仍是一项重要挑战
热管、盖板、热界面材料(TIM)和微通道冷却正在帮助移除芯片产生的热量。
随着半导体集成度不断提高,需要在更小的空间内完成更多工作,这导致产生的热量更多,必须加以散逸。
对先进制程节点芯片以及多芯片集成的热管理,直接决定了它们的性能与寿命。虽然目前大量精力放在提升电源效率(从而减缓功耗增长速度)上,但仅靠这一点远远不够。
还需要多种技术来帮助把热量向上、向下或向外导出。好消息是,多个领域都在取得进展。
更多做功 = 更多热量
电路完成工作所需的能量来自电源引脚,但并非所有能量都转化为有效工作,一部分会以热量的形式浪费掉,必须从热源处移除并排到环境中。要让设计成功,散热速率必须与能量消耗速率达到平衡。除了总功耗之外,芯片内部热量产生区域的面积也至关重要——面积越小,功率密度越高,对先进散热方案的需求就越迫切。
“关键在于要从几平方厘米的小面积里带走几十甚至上百瓦的热量,”Promex 首席运营官 Dave Fromm 表示,“单位面积功率已经非常惊人。”
这个问题还在变得更严重。“功率密度在持续攀升,”Amkor 负责芯片级/FCBGA 集成的副总裁 Mike Kelly 说,“铜混合键合(copper hybrid bonding)等技术加剧了这一问题,因为3D堆叠的总功耗仍然集中在同样的x、y占地面积内。”
硅芯片的最大尺寸受光罩场(reticle,26×33mm)限制,但封装没有这种硬性上限。封装尺寸不能随意增大,部分原因是行业此前未出现大批量超大封装的需求,产线尚未做好准备。不过,封装面积增大本身有助于把热量摊开,降低功率密度。
“我们并不是把所有功能都继续塞进固定尺寸的芯片里,”Kelly 指出,“封装尺寸在变大,这让功率密度要么保持稳定,要么上升得更缓慢。这与受光罩限制的硅芯片完全不同。”
但更大的封装也更容易翘曲。“目前常见的封装本体尺寸是60×60mm²,”Amkor 芯片级/FCBGA开发高级总监 YoungDo Kweon 说,“Amkor 已经量产85×85mm²,几年后会突破100×100mm²,这意味着热应力可能大幅增加。”
材料的热导率单位是 W/(m·K),路径越短热导率越高,因此热传导路径上任何一层越薄越好。
封装内热量如何流动
热量主要产生在有源硅层。随后热量可以:
- 向上:穿过硅衬底背面 → 封装顶部散出(倒装芯片封装最常见路径)
- 向下:通过各种金属互连 → 焊球 → PCB
- 在某些情况下向侧面移动
具体走哪条路径取决于应用场景。
“笔记本电脑通常从芯片背面和主板另一面同时抽热,”Kelly 说,“但在数据中心和高性能计算场景中,向下穿过PCB的热阻非常高,因此95%以上的热量都得从顶部散出。”
散热器与材质选择
高功率封装多年来一直使用铜或铝制散热器(部分带风扇)。金属选择取决于散热器之后热量去向:
- 铝吸热后温度升得更快,温差更大,与空气换热效率更高。
- 铜比热容更高,相同体积下温度变化更慢,更适合把热量传导给下一个固体散热结构,而不适合直接对空气散热。
如果算力负载呈“短时爆发+长时间空闲”特征,铜+风扇也更具优势,能更好地平滑温度峰值。
热点(Hot Spot)问题
芯片局部热点是另一大挑战。与其把整个封装的散热能力设计得足以同时应对所有热点,不如用热扩散器(heat spreader)把热量在封装内部平均开。传统金属扩散器可以是独立的金属块,也可以是与芯片热连接的金属盖。
“最好的热扩散方式是高效地垂直导出热量,”Kelly 说,“如果顶部散热做得足够好,热点根本来不及变热并横向扩散。”
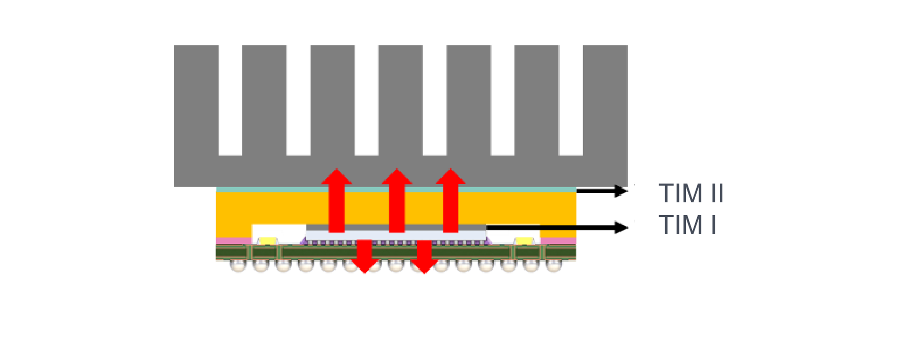 图1 :导热界面材料的两种典型应用。TIM I 位于芯片和散热器之间;TIM II 位于散热器(本例中为外壳)和散热片之间。箭头指示散热方向。来源:Amkor
图1 :导热界面材料的两种典型应用。TIM I 位于芯片和散热器之间;TIM II 位于散热器(本例中为外壳)和散热片之间。箭头指示散热方向。来源:Amkor
热界面材料(TIM)——当前与未来
连接散热器、扩散器等部件的材料称为热界面材料(TIM),其作用是填满两表面间的微小间隙,排除空气。
传统 TIM 多为聚合物,导热性能差,需掺入碳、石墨、金属颗粒或金刚石等高导热填料。即使如此,TIM 层仍应尽量薄。目前100W左右的封装还能应付,但未来1000W级芯片将对现有材料构成巨大挑战。
金属 TIM(尤其是铟合金)正在进入实用阶段,导热率大幅提升。Amkor 测试显示,换用铟合金 TIM 可将结温降低10℃以上。“聚合物 TIM 下每升高10℃,芯片寿命通常减半,”Kweon 说,“现在很多超过400W的芯片,客户都要求使用金属 TIM。”
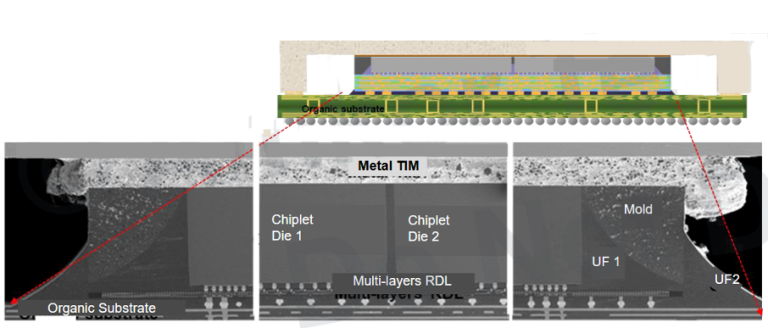 图2 :采用金属导热界面材料的模压 FCBGA。来源:Amkor
图2 :采用金属导热界面材料的模压 FCBGA。来源:Amkor
系统级冷却方案
- 风冷极限:封装功耗达到800–1200W时,风冷基本失效,必须转向液冷。
- 单相液冷:冷板/冷管直接接触封装或芯片背面。
- 两相沸腾流冷却:更先进,利用液体→蒸汽相变带走大量热量。
- 浸没式液冷:整个系统浸入流动的介电液中,散热效率极高,但成本与复杂性也最高。
空间受限时的方案
1. 均热板(Vapor Chamber)
密封腔体内含有少量工质,热侧蒸发、冷侧冷凝,可将局部热点快速摊平到更大面积。目前越来越多高性能封装采用“均热板+冷板”组合。
2. 热管(Heat Pipe)
广泛用于笔记本、手机,把热量从CPU/GPU传到机身边缘再用风扇带走,无需泵,体积小。
无盖(Lidless)封装与直接液冷
去掉金属盖可让芯片背面裸露,便于采用喷射冲击(impingement)等直接液冷技术,热阻极低。但无盖封装在测试和搬运中容易受机械损伤,因此常需在基板边缘加刚性环(stiffener)防翘曲。
微流道冷却(Microfluidics)
在硅芯片或中介层内直接加工微通道,让冷却液从芯片内部带走热量,对3D堆叠中间层芯片尤其有效。目前多为单相,行业正努力将两相微流道推向商用。
向下传热到PCB的路径
- 通过底部焊球、介电附着层(die attach)、内部互连
- 使用高导热共晶合金(如金锡 60 W/mK)或烧结银(70–150 W/mK)可显著改善向下散热
- 未来可能出现高导热陶瓷基板取代有机基板
侧向散热:模塑FCBGA(Molded FCBGA)
在堆叠芯片周围填充高导热模塑料,取代原本的空气,大幅改善侧向散热路径,尤其对被“夹心”的中间芯片有益,同时还能降低先进节点(如2nm)芯片的热机械应力。
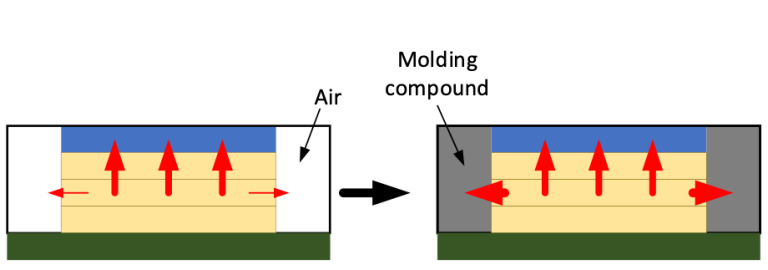 图3 :模塑成型的 FCBGA。模塑材料取代了封装内的空气,改善了侧向散热路径。来源:Bryon Moyer/半导体工程
图3 :模塑成型的 FCBGA。模塑材料取代了封装内的空气,改善了侧向散热路径。来源:Bryon Moyer/半导体工程
总结
芯片和封装产生的热量越来越多,可用的散热技术也在快速增加:金属TIM、均热板、热管、浸没液冷、微流道、模塑封装……各种方案将以不同组合逐步演进。
越早从架构阶段(甚至RTL阶段)开始考虑热设计,越容易在最后取得最佳热性能与成本平衡。
数据中心可以接受昂贵的极端方案,而笔记本、边缘设备仍必须在成本与散热效率之间精打细算。
散热,依然是半导体行业未来十年最关键的挑战之一。
文章来源:Semiconductor Engineering,原标题:Cooling Chips Still A Top Challenge,作者:Bryon Moyer
- 收藏




