基于超表面的光学超透镜的制备与应用综述
引言:
传统光学元件基于光的吸收、折射和反射特性,通过介质中光程的累积来调控光的相位、振幅和偏振态,因此传统光学元件通常体积大、重量沉,无法适应当前光学组件微型化的发展趋势。为此,人工微纳光学器件与材料的研发成为人类探索光的新起点,并衍生出两大研究领域:超材料与超构表面。
1996年,彭德里(Pendry)团队[1]提出了由极细金属线构成的周期性结构,其等效等离子体频率会随金属线间距与线径变化。将等效等离子体频率调节至高于工作频率,即可实现负介电常数。1999年,该团队[2]又提出由非磁性导电薄片构建的开口环阵列结构,通过改变单元结构的尺寸参数与间距,实现了等效负磁导率。2000年,史密斯(Smith)团队[3]基于周期性阵列的开口环与金属线,展示了一种“左手性”复合介质,该介质在微波频段的某一频率范围内,可同时呈现负有效磁导率与负有效介电常数。随着先进微纳加工技术的发展,这种通过人工调控与设计材料光学及电磁效应来引导光传播的理念逐步成为现实,研究人员也由此开启了对超材料的研究[4-15]。超材料已在微波或太赫兹频段得到广泛研究,但在光波频段,超材料的加工制备过程复杂且成本高昂。相比之下,平面人工光学结构的制备难度更低,与光波相互作用时损耗更小,因此受到了广泛关注与研究。
2011年,卡帕索(Capasso)团队[16]提出广义斯涅尔定律,并通过展示具有不同结构参数的V型天线,在亚波长尺度上实现了对线偏振光波0至2π相位的调控,成功完成了透射光波前的操控。超构表面可在亚波长尺度上有效控制光波相位,进而实现对光波前的调控[17-28]。随后,该团队于2012年提出三维广义斯涅尔定律[29];2016年,在可见光波段展示了具有衍射极限聚焦能力与亚波长分辨率成像能力的超构透镜[30];2019年,提出了用于处理傍轴衍射光学中偏振问题的矩阵傅里叶光学[31]。超构透镜为紧凑型集成光学系统提供了极具前景的解决方案,具备体积小、重量轻、成本低、成像性能优的优势。通过调控结构的形状、旋转方向与高度,可实现对光的偏振态、相位与振幅的精确控制。过去十年间,得益于微纳制造技术的进步,超构透镜拥有了极高的设计自由度,能够满足多个领域的应用需求,包括:增强现实/虚拟现实[32-39]、全息成像[40-42]、显微与内窥成像[43-54]、光谱学[55-63]、宽场成像[64-80]、投影仪[81]、光逻辑门[82]、偏振器[83,84]等。
本文综述了超构透镜的制备方法、非成像与成像应用,并探讨了其商业化过程中面临的挑战与前景。在制备部分,总结了微纳结构超构透镜的制造方法,包括两类主要光刻技术:有掩模光刻(光刻、纳米压印光刻)与无掩模光刻(电子束光刻、聚焦离子束光刻、激光直写)。此外,增材制造技术(熔融沉积成型、立体光刻成型、双光子聚合)为制备传统刻蚀技术无法实现的不规则结构定制化超构透镜,提供了新途径。文中还讨论了每种技术的适用场景、局限性及潜在解决方案。
在应用部分,超构透镜在光学领域的应用范围广泛且创新性强。在非成像光学方面,超构表面的非成像光学理论已初步建立,但仍需结合几何光学与波动光学进一步完善框架。超构透镜可对光束进行整形与导向,非常适用于激光系统,且能提升照明效率或个性化定制照明区域;其光能量捕获能力可提高光电探测器的效率,并改善太阳能电池的能量转换效率。在成像光学方面,超构透镜可用于光刻技术以支持微纳加工、辅助天文观测、提升显微与内窥系统的成像质量。基于超构透镜的双光子聚合光刻系统可实现商用级精度;无需额外光学元件的单个超构透镜即可实现望远镜功能;基于超构透镜的显微或内窥系统可进一步缩小体积,尤其适用于在体成像系统。
最后,本文探讨了超构透镜从实验室走向商业化所需的环境适应性、超构透镜的逆向设计方法、性能评估方法,以及其在新兴领域的部分应用(如无人机平台、自动驾驶中的感知与探测、量子光学、光帆等)。此外,与人工智能的结合可能是其未来的发展趋势。总之,超构透镜拥有传统光学透镜无法比拟的高光学调控自由度,且具备与半导体制造工艺兼容的特性,能够与现有光电器件设计相集成,必将推动下一代光学技术的发展。
超构透镜制造技术:
有掩模光刻——光刻技术
光刻技术是目前应用最广泛的微纳制造技术,通过将设计好的图案转移到光敏材料上,为各领域微纳结构的制造提供技术支撑。尽管光刻技术受衍射效应限制(遵循摩尔定律[85]),但其具备高精度、高分辨率、大规模并行加工能力及高自动化程度,因此可轻松完成亚波长尺度超构表面的制造。
通过优化光刻过程中的参数与方法,可提升光刻的精度和分辨率,以满足超构表面制造的精度需求。其大规模并行加工能力,以及与互补金属氧化物半导体(CMOS)工艺制造方法的兼容性,也为超构表面制造提供了更多可能。
超构表面的制造流程与成熟集成电路产业的传统工艺一致,结合算法有望实现传统设计无法达成的厘米级尺寸制造。相关研究案例如下:
• She等人[86]:采用压缩算法设计出直径2厘米的大规模超构透镜,制造流程为典型的“自上而下”刻蚀法:
1. 通过等离子体增强化学气相沉积(PECVD)技术,在4英寸熔融石英(SiO₂)晶圆衬底上沉积0.6μm厚的非晶硅(a-Si)层;
2. 依次旋涂并烘烤附着力促进剂、1.1μm厚光刻胶及0.4μm厚光漂白对比度增强材料;
3. 采用5倍缩小步进光刻技术对光刻胶进行图形化处理,每小时可处理数百片晶圆;
4. 利用感应耦合等离子体反应离子刻蚀(ICP RIE)技术刻蚀a-Si层,形成纳米结构;
5. 剥离剩余光刻胶,最终样品如图1a所示。研究还指出,约十年前的芯片制造技术即可生产超构透镜,这让老旧设备重新发挥作用,且最先进设备并非实现该目标的必要条件。
• Park等人[87]:研制出直径1厘米、数值孔径(NA)为0.1、工作于可见光波段的全玻璃超构透镜:
1. 在直径100毫米的SiO₂晶圆衬底上沉积100纳米厚的铬(Cr)层(作为硬掩模);
2. 采用4倍缩小步进光刻技术对光刻胶进行图形化处理;
3. 利用ICP技术刻蚀Cr层,再通过ICP技术刻蚀SiO₂层形成纳米结构;
4. 剥离剩余Cr,最终样品如图1b所示。
• Colburn等人[88]:受阿尔瓦雷斯透镜启发,结合两个独立超构表面,提出工作于近红外(NIR)波段、孔径1厘米、大面积且焦距可调的超构透镜系统:
1. 通过PECVD技术在直径100毫米的硅(Si)晶圆衬底上沉积2μm厚的氮化硅(SiN)层;
2. 采用5倍缩小步进光刻技术对光刻胶进行图形化处理(如图2a所示);
3. 蒸发沉积150纳米厚的铝(Al)层(作为硬掩模),随后剥离光刻胶;
4. 利用ICP技术刻蚀SiN层形成纳米结构;
5. 剥离剩余Al,最终样品如图1c所示。
此外,可见光超构表面需具备百纳米以下的尺寸,而光刻技术可实现其批量生产。
【图1:通过光刻技术制备的超构透镜图像】

• 图1a:4个制备完成的直径20毫米超构透镜实物图(带直尺测量);扫描电子显微镜(SEM)图像显示环形排列的非晶硅(a-Si)纳米柱,比例尺为2微米。(转载自文献[86],经美国光学学会授权,版权所有2018)
• 图1b:4英寸二氧化硅(SiO₂)晶圆上制备的45个直径10毫米超构透镜实物图。(转载自文献[87],经美国化学会授权,版权所有2019)
• 图1c:完全曝光显影后的直径100毫米晶圆实物图,体现其大面积器件制备能力。
• 图1d:制备完成的带有彩色“IME”标识的超构表面实物图。
• 图1e:12英寸玻璃晶圆上制备的样品实物图,以及中心芯片实物图(高亮区域标注超构透镜位置)。
• 图1f:包含5000个超构透镜的磷化铟(InP)晶圆制备实物图。
• 图1g:4英寸熔融石英晶圆上制备的完整直径80毫米超构透镜实物图,可隐约识别出图案拼接的边界。
• 图1h:制备完成的直径50毫米超构透镜整体实物图(带卡尺测量);插图为超构透镜的侧视图。
• 图1i:6英寸熔融石英晶圆上制备的完整直径100毫米超构透镜实物图(与乒乓球拍对比展示)。
*图1各子图补充版权信息
• 图1c:转载自文献[88],经美国光学学会(Optical Society of American)授权,版权所有2018年。
• 图1d:转载自文献[89],经美国光学学会授权,版权所有2018年。
• 图1e:转载自文献[90],经德古意特出版社(De Gruyter)授权,版权所有2020年。
• 图1f:转载自文献[91],经施普林格·自然出版集团(Springer Nature)授权,版权所有2024年。
• 图1g:转载自文献[95],经美国光学学会授权,版权所有2023年。
• 图1h:转载自文献[96],经美国科学促进会(American Association for the Advancement of Science)授权,版权所有2024年。
• 图1i:转载自文献[97],经美国化学会(American Chemical Society)授权,版权所有2024年。
光刻技术制备超构表面/超构透镜的研究案例
1. Hu等人[89]:百纳米级关键尺寸的彩色显示超构表面
该超构表面关键尺寸小于100纳米,制造流程如下:通过等离子体增强化学气相沉积(PECVD)技术,在12英寸硅晶圆衬底上依次沉积70纳米厚的氮化硅(SiN)层与130纳米厚的非晶硅(a-Si)层;如图2a所示,采用ArF浸没式光刻技术对光刻胶进行图形化处理,再通过感应耦合等离子体(ICP)技术刻蚀a-Si层形成纳米结构;最后剥离剩余光刻胶。其反射光谱显示,超构表面在675纳米、570纳米和420纳米波长处产生共振,分别呈现红、绿、蓝三色,最终实现“工”(I)、“M”、“E”字母的彩色显示(如图1d所示)。
2. Hu等人[90]:940纳米波长指纹成像用超构透镜
该超构透镜直径2毫米,工作于940纳米波长,制造流程引入了层转移工艺(解决玻璃晶圆光刻蚀刻难题):首先通过PECVD技术在12英寸硅晶圆衬底上依次沉积1微米厚的二氧化硅(SiO₂)层与600纳米厚的a-Si层;如图2a所示,采用ArF浸没式光刻技术对光刻胶图形化,通过ICP技术刻蚀a-Si层形成纳米结构;随后在图案化硅晶圆上涂覆60微米厚的硅氧烷中间层,并与12英寸玻璃晶圆键合;接着对硅晶圆背面进行研磨抛光,将其厚度减至约20微米,再通过湿法刻蚀去除剩余硅层,直至刻蚀到SiO₂停止层;最终样品如图1e所示。
3. De Vocht等人[91]:无需金属硬掩模的宽带消色差超构透镜
该超构透镜消色差能力提升40%,且无需金属硬掩模,制造流程如下:在3英寸磷化铟(InP)晶圆衬底上依次沉积2微米厚的SiO₂层与750纳米厚的氮化硅(Si₃N₄)层;依次旋涂并烘烤抗反射涂层(ARC)、光刻胶与ARC;如图2a所示,采用4倍缩小步进光刻技术对光刻胶图形化;通过感应耦合等离子体反应离子刻蚀(ICP RIE)技术刻蚀Si₃N₄层形成纳米结构;最后剥离剩余光刻胶与ARC。最终样品如图1f所示,单个晶圆上包含5000个超构透镜。
不同应用场景下的超构透镜光刻制备技术
工作于可见光与近红外(NIR)波段的超构透镜,大多制备在二氧化硅(SiO₂)衬底上。但SiO₂在中红外(MIR)波段存在明显的吸收损耗,而硅(Si)等其他衬底则易产生反射损耗,因此亟需创新制造方法来制备中红外波段的超构表面。
1. Leitis等人[92]:中红外波段超构表面的CMOS兼容制造方法
为解决中红外超构表面制造中“适宜光学特性材料选择有限”的难题,Leitis团队提出了一种新方法。该技术采用CMOS工艺在Si晶圆上制备超构表面,通过深紫外(DUV)光刻技术可制作出光学透明的氧化铝(Al₂O₃)薄膜。这些纳米级薄膜厚度约100nm,在2-20μm的宽中红外波段内,不仅具备优异的透射性能,其有效折射率还与1高度接近。
2. Hu等人[92]:用于大视场显微镜的超构透镜阵列
单个超构透镜集成在传感器上难以实现大视场(FOV),为此Hu团队展示了一种与传感器集成的超构透镜阵列,可用于大视场显微镜。他们基于4倍缩小步进光刻技术,通过标准Si纳米制造工艺,仅用一个超构透镜掩模就完成了阵列制备。
为提升制造质量,团队还提出了一种针对所用光刻机的“掩模补偿方法”:制作光栅样品,将其特征尺寸与设计值对比,通过优化掩模设计来补偿尺寸差异。该方法可将器件设计值与实际制造值的平均尺寸偏差控制在30nm以内。此外,在掩模设计中采用光学邻近校正[93]技术,可进一步提高制造精度。
3. Yang等人[94]:多层柔性超构透镜
介电超构透镜虽具有优异的透射效率,但柔性或多层器件的制备仍面临巨大挑战。Yang团队提出了一种多层超构透镜,采用多层光刻技术制备出集成三个超构表面的超构透镜。
该超构透镜包含三层铝(Al)膜(每层厚度200nm),层间穿插两层厚度为50μm的聚酰亚胺(PI)膜;同时额外添加10μm厚的顶层PI膜与10μm厚的底层PI膜作为保护层。最终制备的样品由四层柔性PI膜与三层Al膜构成,这种基于“金属-介质-金属”三明治结构的超构透镜,可实现二次相位分布。
基于多曝光与图案拼接的大尺寸超构透镜制备技术
1. Zhang等人[95]:80mm孔径超构透镜望远镜系统(旋转拼接法)
• 核心应用:研制80mm孔径超构透镜,用于天文图像捕获的望远镜系统,通过多曝光+图案旋转拼接实现大尺寸制备(对应图2b),最终样品可隐约看到拼接边界(图1g)。
• 制备流程:
1. 在4英寸熔融石英晶圆上沉积1μm厚的非晶硅(a-Si)层,依次旋涂并烘烤60nm厚抗反射涂层(ARC)与600nm厚光刻胶;
2. 采用4倍缩小步进光刻技术,用4块掩模(每块含4个图案,共16个图案)通过旋转拼接法对光刻胶图形化;
3. 氧等离子体去除ARC层后,用ICP RIE技术刻蚀a-Si层形成纳米结构;
4. 氧等离子体去除剩余光刻胶与ARC,完成制备。
2. Hou等人[96]:5cm孔径中红外热成像超构透镜(多掩模联合步进光刻)
• 核心突破:针对传统中红外透镜孔径小、受温度影响大的问题,开发“多掩模联合步进光刻”技术,制备5cm大孔径超构透镜,用于热成像相机(对应图2c,样品见图1h)。
• 制备流程:
1. 在6英寸硅晶圆上旋涂并烘烤光刻胶;
2. 采用步进光刻技术,用9块不同掩模曝光出9个独立图案,通过对准标记精准定位拼接,同步生成4个完整超构透镜图案;
3. ICP技术刻蚀硅层形成纳米结构;
4. 剥离剩余光刻胶,得到最终样品。
3. Park等人[97]:100mm直径全玻璃宇宙成像超构透镜(对称复用拼接)
• 核心成果:制造含187亿个纳米结构的100mm直径全玻璃超构透镜,用于宇宙成像,通过旋转对称复用仅用7块掩模实现5×5网格(25个区域)的拼接(对应图2d,样品见图1i)。
• 制备流程:
1. 电子束蒸发(EBE)技术在6英寸熔融石英晶圆上沉积150nm厚铝(Al)层,依次旋涂烘烤62nm厚ARC与600nm厚光刻胶,用4倍缩小步进光刻制作对准标记;
2. RIE刻蚀ARC暴露Al层,湿法刻蚀去除120nm厚Al层以适配光刻系统相位对比检测,氧等离子体去除剩余光刻胶与ARC;
3. 再次旋涂烘烤62nm厚ARC与500nm厚光刻胶,用7块掩模通过旋转拼接法图形化;
4. ICP RIE刻蚀ARC暴露Al层,再刻蚀Al层作为硬掩模,等离子处理去除残留光刻胶与ARC;
5. ICP RIE刻蚀SiO₂层形成1.5μm高纳米结构,最后刻蚀去除剩余Al层。
【基于步进光刻机的超构透镜图形化方法】
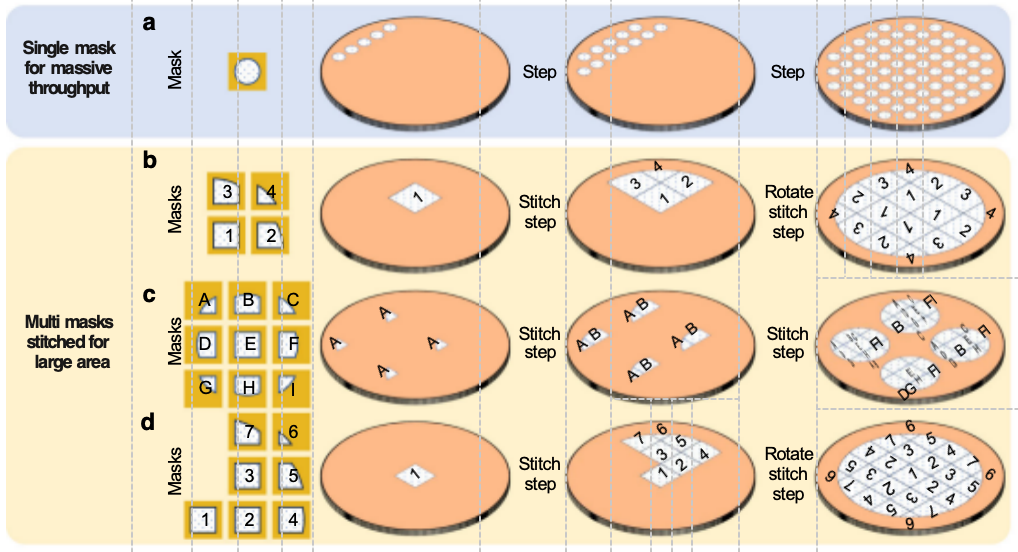
• 图2a:传统步进法
通过单一掩模实现超构透镜图形化,可一次性获得大量超构透镜图案,是流程相对简单的常规图形化方式。
• 图2b-2d:旋转拼接法
采用多个掩模,通过旋转掩模并将不同掩模对应的图案进行拼接,最终得到大面积超构透镜图案,适用于需要扩大图案覆盖范围的场景。
• 图2c:分步拼接法
同样使用多个掩模,通过分步移动掩模并逐段拼接图案的方式,实现大面积超构透镜的图形化,可灵活调整拼接精度以适配不同尺寸需求。
超构透镜制造技术:有掩模光刻——纳米压印光刻(NIL)
当前,受紫外光波长衍射极限与驻波效应影响,光刻设备发展陷入瓶颈,光刻精度受限。在此背景下,一种新技术应运而生:纳米压印光刻(NIL)由Chou等人[98]于1995年提出,此后众多学者对其展开广泛研究。
从本质上讲,纳米压印光刻是液态聚合物填充模板结构空腔、固化后脱模的过程,因此其分辨率仅与模板尺寸相关,不受光波长、物镜数值孔径(NA)、聚焦系统等因素限制,突破了传统光学曝光光刻工艺的分辨率瓶颈。此外,该技术还具备高深宽比(AR)、高效率、低成本、高产量等优势。
起初,超构表面制造过程中,纳米压印技术仅用于光刻胶图形化,后续应用逐步拓展:
1. 2014年Yao等人[99]:高对比度光栅(HCG)
为制备二维孔阵列硅母版,先通过干涉光刻技术制作一维周期性光栅硅母版,再复制得到柔性聚二甲基硅氧烷(PDMS)模板;用该模板在硅衬底的光刻胶上沿正交方向两次压印,随后沉积铬(Cr)、剥离光刻胶、刻蚀硅以形成二维孔阵列,再剥离Cr;以二维孔阵列硅母版为基础,复制另一块二维PDMS模板;通过磁控溅射技术在二氧化硅(SiO₂)衬底上沉积二氧化钛(TiO₂)层,用二维PDMS模板对TiO₂层上的光刻胶压印,之后沉积Cr、剥离光刻胶、刻蚀TiO₂与SiO₂层形成纳米结构,最后剥离Cr,得到最终样品(见图3h)。
2. 2016年Yao等人[84]:可见-红外波段高对比度非对称透射堆叠超构表面
先通过干涉光刻制作一维周期性光栅硅母版,复制得到压印模板;在SiO₂衬底上制作高度190nm的一维铝(Al)光栅,随后旋涂355nm厚光刻胶并固化,作为缓冲层;采用等离子体增强化学气相沉积(PECVD)技术在缓冲层上沉积510nm厚氮化硅(SiNₓ)层;用一维混合光栅模板对SiNₓ层上的光刻胶压印,之后沉积Cr、剥离光刻胶、刻蚀SiNₓ层形成纳米结构,最后剥离Cr,得到最终样品(见图3i)。
3. 2018年Lee等人[100]:直径20mm、数值孔径0.61的透明超构透镜
先通过电子束光刻(EBL)制作硅母版,复制得到聚氨酯丙烯酸酯(PUA)压印模板;采用电子束蒸发(EBE)技术在PUA模板上依次沉积5nm厚金(Au)、25nm厚Cr、10nm厚SiO₂层;通过低压化学气相沉积(LPCVD)技术在石英晶圆衬底上沉积100nm厚多晶硅(p-Si)层,随后在其表面旋涂10nm厚粘结层;将带有Au/Cr/SiO₂的PUA模板通过粘结层与石英衬底的p-Si层贴合,加压辅助完成沉积物质的图案转移;以转移的Cr图案为硬掩模,刻蚀p-Si层形成纳米结构;最后剥离Cr并清洗超构透镜,完成制备。
【图3:基于纳米压印光刻(NIL)技术的超构透镜制备方法与图像】

一、制备方法示意图(Schematic)
• 图3a:简易纳米铸造(nanocasting)制备流程示意图。(转载自文献[101],经美国化学会授权,版权所有2019年)
• 图3b:基于纳米复合材料的制备流程示意图。(转载自文献[103],经美国化学会授权,版权所有2021年)
• 图3c:含印章制备(旋涂、热固化)与压印(旋涂、印章放置、紫外固化、印章剥离)的制备流程示意图,可批量生产数万个器件。(转载自文献[104],经美国化学会授权,版权所有2021年)
• 图3d:基于原子层沉积(ALD)技术的制备流程示意图。(分别转载自文献[104]、[105];文献[104]版权2021年美国化学会,文献[105]经施普林格·自然授权,版权所有2023年)
• 图3e:扭曲双层超构器件制备流程示意图,顶层通过反向纳米压印与底层形成扭转角。(转载自文献[107],经德古意特出版社授权,版权所有2023年)
• 图3f:基于湿法刻蚀技术的制备流程示意图。(分别转载自文献[104]、[108];文献[104]版权2021年美国化学会,文献[108]经施普林格·自然授权,版权所有2023年)
• 图3g:胶带辅助制备流程示意图,可复制无残留层的超构原子。(转载自文献[112],经约翰·威利父子出版社授权,版权所有2025年)
二、制备样品图像(Images of Fabricated Devices)
• 图3h:二氧化钛-二氧化硅(TiO₂-SiO₂)双层纳米柱结构高对比度光栅的扫描电子显微镜(SEM)图像。(转载自文献[99],经美国真空学会授权,版权所有2014年)
• 图3i:含氮化硅(SiNₓ)超构光栅、缓冲层与铝(Al)超构光栅的超构偏振器SEM图像。(转载自文献[84],经美国光学学会授权,版权所有2016年)
• 图3j:含不同尺寸、高深宽比(AR)TiO₂ PER纳米柱的超构透镜SEM图像。(转载自文献[104],经美国化学会授权,版权所有2021年)
• 图3k:含中间层的双层超构器件横截面SEM图像。(转载自文献[107],经德古意特出版社授权,版权所有2023年)
• 图3l-3n:不同衬底上复制的超构表面实物图:玻璃衬底(l)、曲面衬底(m)、柔性衬底(n),插图为超构表面俯视图。(转载自文献[101],经美国化学会授权,版权所有2019年)
• 图3o-3r:不同衬底上复制的超构透镜实物图:玻璃衬底(o)、柔性衬底(p)、凸面衬底(q)、凹面衬底(r)。(转载自文献[108],经施普林格·自然授权,版权所有2023年)
传统纳米压印光刻(NIL)技术的局限性与创新方案(Kim等人[101],2019年)
传统纳米压印光刻(NIL)技术通常需要沉积、刻蚀等额外工艺,导致生产效率降低、衬底兼容性受限且价格竞争力下降。
2019年,Kim等人[101]提出一种低成本、高效率的纳米铸造方法,用于制备介电超构表面,无需额外工艺,这一方案基本奠定了当前超构表面纳米压印主流方法的基础,其制备流程如图3a所示:
1. 从母版复制得到高硬度聚二甲基硅氧烷(h-PDMS)模板,复制分辨率可达100纳米以下;
2. 在h-PDMS模板表面涂覆一层PDMS作为缓冲层;
3. 在h-PDMS模板上旋涂一层粒子嵌入树脂(PER)以形成纳米结构——PER是一种低损耗材料,由二氧化钛(TiO₂)纳米颗粒与紫外(UV)固化树脂组成;
4. 将h-PDMS模板的PER面朝下放置在玻璃衬底上,通过加压与紫外曝光完成图案转移;
5. 最后平稳剥离h-PDMS模板即可。
PER层的折射率足够高,使其无需刻蚀或沉积工艺就能满足超构表面的结构化需求。此外,该方法可适用于多种衬底,如玻璃衬底(图3l)、曲面衬底(图3m)和柔性衬底(图3n)。随后,Yoon等人[102]采用与上述类似的方法制备超构透镜,差异在于:PER并非旋涂在模板上,而是滴涂在玻璃衬底上。
超构透镜制造:新型脱模工艺与TiO₂基纳米颗粒油墨方案
1. Yoon等人[103](2021年):基于自组装单分子层(SAM)的新型脱模工艺
该工艺通过SAM实现顺畅脱模,流程如图3b所示:首先在母模上涂覆液相SAM;随后复制母模制备高弹性聚二甲基硅氧烷(h-PDMS)模具,并在其表面涂覆PDMS层作为缓冲层;将硅纳米复合材料旋涂于h-PDMS模具上形成纳米结构;接着将h-PDMS模具倒扣在玻璃衬底上,施加压力与热量完成转移;最后移除h-PDMS模具。
2. Einck等人[104]:0.2数值孔径(NA)超构透镜(TiO₂基纳米颗粒油墨方案)
该方案需解决TiO₂作为光氧化催化剂易导致聚合物基质中碳成分发黄、进而降低超构透镜效率的问题,制造流程如图3c所示:首先通过电子束光刻(EBL)技术制备硅母模,复制得到h-PDMS模具;在h-PDMS模具上涂覆PDMS层作为应力消散层;将TiO₂基纳米颗粒油墨(其紫外辅助固化过程利用TiO₂的光催化特性,最终形成无机物)旋涂于硅衬底;随后将h-PDMS模具倒扣在玻璃衬底上,施加压力并紫外照射形成纳米结构;最后移除h-PDMS模具。最终样品如图3j所示,压印形成的纳米柱Aspect Ratio(长径比)高达7.8。
超构透镜批量制造与创新工艺研究案例(2023年及相关)
1. Kim等人[105]:12英寸浸没光刻与原子层沉积(ALD)结合的批量制造
该方案实现1厘米孔径超构透镜高效量产,流程如图3d所示:通过ArF浸没光刻技术制备含669个1厘米直径超构透镜图案的12英寸硅母模,复制得到h-PDMS模具;将树脂旋涂于h-PDMS模具形成纳米结构,随后将模具倒扣在玻璃衬底上,施加压力并紫外曝光完成转移,再移除模具;最后通过ALD技术在纳米结构表面沉积TiO₂薄膜以提升转换效率。此工艺依托12英寸模具压印,可实现75纳米线宽、40纳米间隙的关键尺寸;4英寸晶圆超构透镜转移良率达95%,但晶圆尺寸增大时良率会下降。
2. Ishii等人[106]:镍(Ni)模具与注塑成型的高长径比(AR)结构复制
该方法通过注塑成型实现高AR纳米结构的可重复、高吞吐量制造,流程如下:从母模复制得到初始模具,在玻璃衬底旋涂混合聚合物后覆盖模具,施压并紫外曝光形成纳米结构,移除模具;通过共形沉积与电镀技术在纳米结构化玻璃衬底上沉积Ni层,制成Ni压模并从衬底剥离;最后使用注塑机和Ni压模,以热塑性塑料(聚碳酸酯、Iupizeta)为原料制造超构透镜,可实现多级纳米柱结构。
3. Chen等人[107]:SU-8双层超构器件(相对扭转角设计)
针对低折射率材料(如SU-8光刻胶)设计超构表面的难题,提出双层扭转结构方案,流程如图3e所示:在0.5毫米厚载玻片上涂覆并烘烤180纳米厚SU-8层(作为黏合层),再涂覆350纳米厚SU-8层并烘烤,用硅烷涂层IPS模具施压并紫外曝光压印,脱模后得到280纳米深纳米孔阵列(下层结构);在硅烷涂层IPS模具上涂覆350纳米厚SU-8层,将此模具以64.4°旋转角倒扣在下层结构上,施压并紫外曝光(增强上下层结合),形成280纳米深纳米孔阵列(上层结构),最后移除IPS模具。图3k展示了含中间层的双层超构器件横截面。
4. Choi等人[108]:无脱模过程的湿法刻蚀纳米压印光刻(NIL)
该工艺解决传统h-PDMS模具NIL导致的剪切应力与结构损伤问题,流程如图3f所示:通过电子束光刻(EBL)制备硅母模,涂覆液相SAM以辅助脱模;复制得到水溶性聚乙烯醇(PVA)模具;将TiO₂光刻胶(PER)旋涂于PVA模具,倒扣在预处理衬底上,施压并紫外曝光完成转移;最后用去离子水湿法刻蚀移除PVA模具(无外部压力损伤纳米结构)。此方法兼容多种衬底,包括玻璃衬底(图3o)、柔性衬底(图3p)、凸面衬底(图3q)和凹面衬底(图3r)。
超构透镜光刻制造技术研究进展(2023-2025)及有掩模光刻总结
一、2023-2025年关键研究案例
1. Kim等人[105](2023年):1厘米孔径超构透镜高效量产
采用浸没式光刻制备母版,结合原子层沉积(ALD)提升转换效率,流程如下:通过ArF浸没式光刻技术制备含669个1厘米直径超构透镜图案的12英寸硅母版,复制得到h-PDMS模具;在h-PDMS模具上旋涂树脂形成纳米结构,倒扣于玻璃衬底,施加压力并紫外曝光完成转移后移除模具;最后通过ALD技术在纳米结构表面沉积TiO₂薄膜。该技术可实现75纳米关键尺寸与40纳米间隙,4英寸晶圆转移良率达95%,但晶圆尺寸增大时良率会下降。
2. Ishii等人[106](2023年):注塑成型制备高长径比(AR)超构透镜
利用镍(Ni)模具与注塑成型技术实现高重现性、高吞吐量制造:从母版复制得到模具,在玻璃衬底旋涂混合聚合物,压模并紫外曝光形成纳米结构后脱模;通过共形沉积与电镀技术在纳米结构化玻璃衬底上沉积Ni层,制成Ni压模;最后使用注塑机与Ni压模,以热塑性塑料(聚碳酸酯、Iupizeta)为原料制备超构透镜。
3. Chen等人[107](2023年):双层扭转超构器件(低折射率材料方案)
针对SU-8光刻胶等低折射率材料设计难题,提出双层扭转结构:在0.5毫米厚载玻片上涂覆并烘烤180纳米厚SU-8层(黏合层),再涂覆350纳米厚SU-8层并烘烤,用硅烷包覆的IPS模具压印并紫外曝光,脱模后得到280纳米深纳米孔阵列(下层);在硅烷包覆的IPS模具上涂覆350纳米厚SU-8层,将其以64.4°旋转角倒扣于下层,施压并紫外曝光增强层间结合,形成280纳米深纳米孔阵列(上层),最终脱模。成品横截面如图3k所示(含中间层)。
4. Choi等人[108](2023年):无脱模湿法刻蚀纳米压印光刻(NIL)
解决h-PDMS模具引发的剪切应力损伤问题,流程如下:通过电子束光刻(EBL)制备硅母版,涂覆液相SAM便于脱模;复制得到水溶性聚乙烯醇(PVA)模具;在PVA模具上旋涂TiO₂光敏树脂(PER),倒扣于预处理衬底,施压并紫外曝光完成转移;最后用去离子水湿法刻蚀移除PVA模具,该过程不会对纳米结构施加外部压力,且兼容玻璃、柔性、凸面、凹面等多种衬底(如图3o-r所示)。
5. Park等人[42]与Kim等人[109,110](2024年):步进光刻+NIL量产超构表面/紫外超构透镜
• Park等人[42]:用ArF步进光刻制备含266个超构表面的8英寸硅母版,复制h-PDMS模具;在模具上旋涂TiO₂ PER,倒扣于8英寸玻璃衬底,施压并加热转移后脱模,实现低成本、高吞吐量制造。
• Kim等人[109,110]:基于上述方法量产1厘米直径、0.2数值孔径(NA)的高效紫外超构透镜:在h-PDMS模具上涂覆PDMS缓冲层,旋涂紫外固化树脂后倒扣于8英寸SiO₂衬底,施压并紫外曝光转移;最后通过等离子体增强原子层沉积(PEALD)技术沉积二氧化锆(ZrO₂)薄膜,大幅提升转换效率(TiO₂在紫外区吸收损耗高,ZrO₂更适配紫外波段)。
6. Kang等人[111](2024年):ZrO₂ PER替代方案(紫外波段优化)
针对TiO₂在紫外区高吸收损耗的问题,提出用ZrO₂ PER替代:ZrO₂在320纳米波长处折射率约1.8且透光性好,更适合紫外波段超构器件制造。
7. Park等人[112](2025年):胶带辅助PER-NIL(残留层去除)
解决高折射率残留层引入噪声、限制性能的难题,流程如下:通过EBL制备硅母版,复制得到甲苯稀释PDMS软模;在软模上涂覆TiO₂ PER,用胶带粘贴-剥离以均匀去除残留层(重复至软模洁净);将含PER的软模压于预处理衬底,施压并紫外曝光转移后轻脱模。该技术适用于介电结构色或全息超构表面制造,成品结构色超构表面具有传统NIL无法实现的尖锐单反射峰,全息超构表面在宽波长范围内成像质量更优。
二、有掩模光刻技术总结
有掩模光刻制造超构透镜/光学超构表面的两大核心技术及关键方向如下:
• 光刻技术:无需量产时,成熟光刻技术制造研究用超构透镜成本较低(半导体级精度,成本低于EBL)。但现有深紫外(DUV)光刻设备向研究市场普及需时间,且大面积多掩模超构透镜需突破高精度标记对准、图案边界重合与过渡等技术难点。
• 纳米压印光刻(NIL)技术:需量产(尤其未来消费级设备商用)时,NIL成本优势显著(单母版可短时间压印多个器件)。但需进一步研究母版纳米结构磨损、每次压印后残留聚合物去除,以及如何与现有芯片冲压设备整合实现标准化生产。
此外,超构表面制造还可采用自组装光刻[113-120]、印刷电路技术[121-123]、贴花转移技术[124]、纳米削切技术[125,126]、对准-键合-剥离技术[127]等方法。
无掩模光刻技术
传统光刻技术加工表面微纳结构的精度,主要取决于掩模板的精度。尽管高精度掩模板的加工方法已相对成熟,但制备掩模板需用到掩模图形数据处理系统、光学图形发生器、掩模光刻胶涂胶机、掩模显影机、掩模复制机等设备,流程极为复杂且成本高昂。
因此,电子束光刻、聚焦离子束光刻、激光直写等无掩模光刻技术,正受到研究人员越来越多的关注。
电子束光刻技术(EBL)
电子束光刻(EBL)是一种无掩模光刻技术,通过波长极短的聚焦电子束直接作用于电子敏感光刻胶表面,绘制出与设计图案一致的微纳结构。
其核心优势在于超高分辨率与图案化灵活性,但受限于曝光效率低、控制流程复杂,目前更常用于制造光刻掩模、先进原理样机及纳米级科学研发,而非大规模量产。
传统“自上而下”刻蚀法制造超构表面时,通常采用EBL技术进行图案定义(如图4a所示),但需配套沉积、刻蚀、剥离等工艺,易引入制造缺陷。此外,还有一种新型“自下而上”沉积法可用于超构表面制造(如图4b、c所示),后续将详细说明。
【图4:超构表面制造流程示意图】
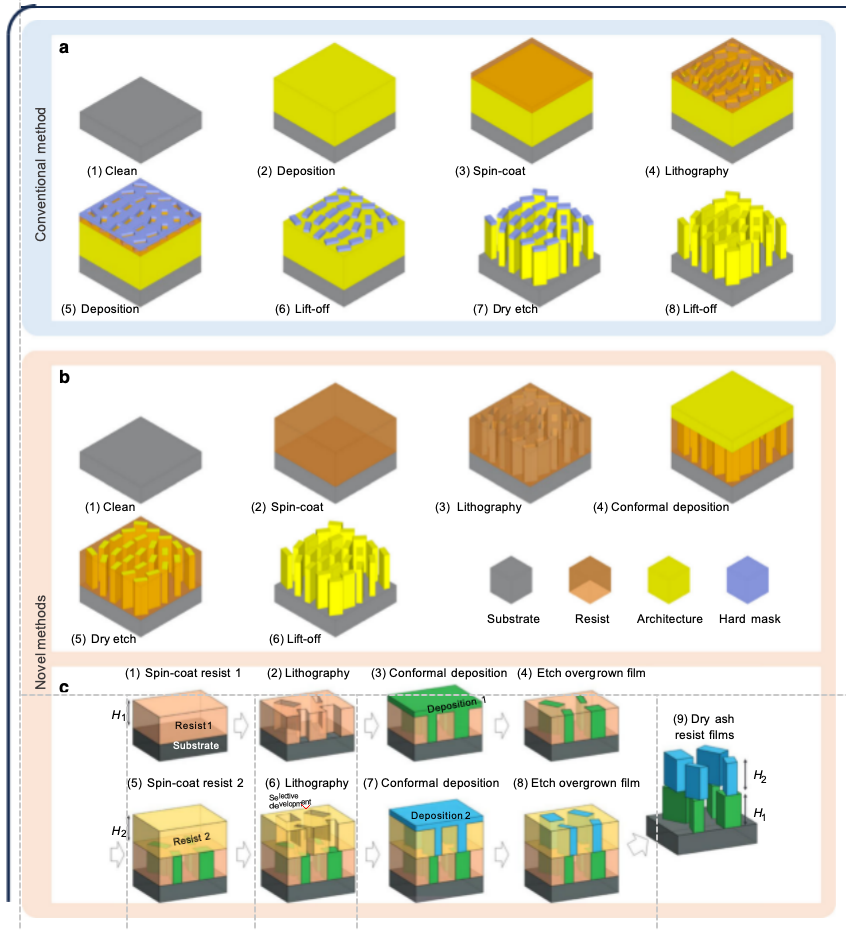
• 图4a:传统“自上而下”刻蚀法制造超构表面的流程示意图。该方法通常以电子束光刻(EBL)定义图案,需结合沉积、刻蚀、剥离等后续工艺。
• 图4b:新型“自下而上”沉积法制造超构表面的流程示意图(通过图案化电子束诱导沉积(EBR)定义纳米结构),图中无比例关系。
• 图4c:自支撑双层超构表面的制造流程示意图。
(转载自文献[140],经施普林格·自然出版集团(Springer Nature)授权,版权所有2025年)
基于电子束光刻(EBL)的超构器件制造案例
电子束光刻(EBL)基于扫描原理,能够定义多种复杂图案,以下为具体应用案例:
1. Wang等人[128]:近红外(NIR)波段宽带消色差超构透镜
该超构透镜可将不同波长的光汇聚到同一焦平面,制造流程如下:通过电子束蒸发(EBE)技术在硅(Si)衬底上依次沉积150纳米厚的金(Au)层与3纳米厚的铬(Cr)膜;再通过等离子体增强化学气相沉积(PECVD)技术沉积60纳米厚的二氧化硅(SiO₂)层;旋涂并烘烤100纳米厚的电子束抗蚀剂(EBR)层,采用EBL技术对EBR进行图形化处理;在图案化衬底上依次沉积3纳米厚的Cr膜与30纳米厚的Au层;最后剥离剩余EBR,最终样品如图5a所示。
2. Yao等人[130]:非局域超构透镜(新月形纳米结构)
制造流程如下:通过EBE技术在SiO₂衬底上依次沉积327纳米厚的非晶硅(a-Si)层与22纳米厚的Cr层(作为硬掩模);在样品上旋涂并烘烤80纳米厚的聚甲基丙烯酸甲酯(PMMA)层,采用EBL技术对PMMA进行图形化处理;通过感应耦合等离子体(ICP)技术依次刻蚀Cr层与a-Si层,形成纳米结构;最后去除剩余Cr,最终样品如图5b所示,由新月形纳米结构组成。
此外,EBL技术还可用于制造中心对称排列的超构光栅结构[129]。
【图5 采用电子束光刻(EBL)技术制备的超构透镜图像】
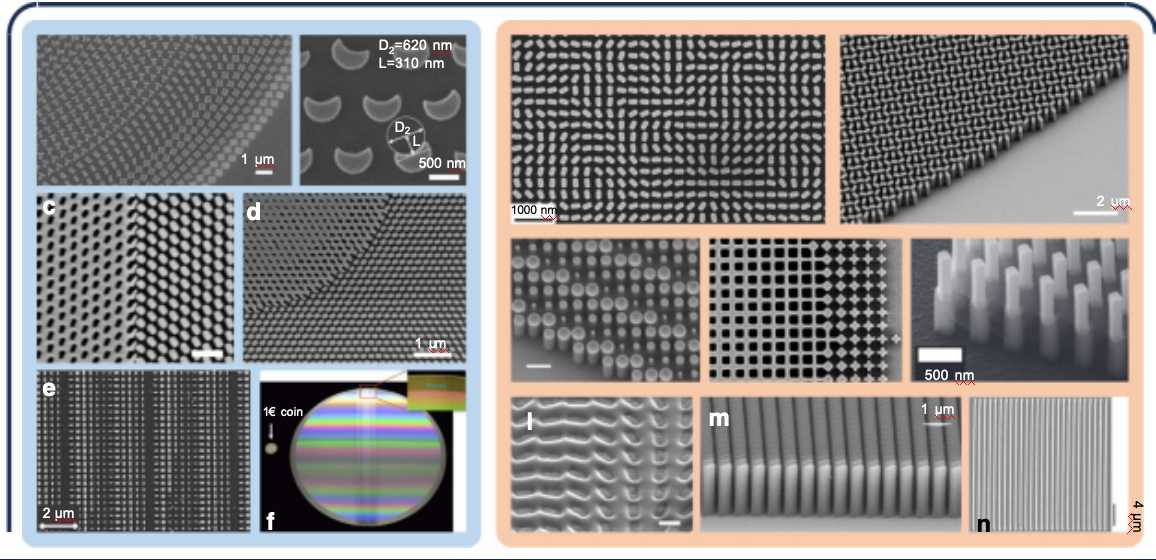
• a 具有不同金(Au)超原子的超构透镜扫描电子显微镜(SEM)图像。
• b 具有不同尺寸新月形纳米结构(集成共振单元)的制备超构透镜SEM图像。
• c 具有不同取向互补氮化镓(GaN)纳米鳍片的制备超构透镜SEM图像,比例尺:10微米(μm)。
• d 具有不同取向互补氮化镓(GaN)纳米鳍片的制备超构透镜SEM图像。
• e 具有不同尺寸银(Ag)纳米结构的制备超构曲面反射镜SEM图像。
• f 300毫米(mm)直径硅(Si)晶圆上制备的280毫米直径纳米压印母版照片,与1欧元(€)硬币对比。
• g 具有不同取向高纵横比(AR)二氧化钛(TiO₂)纳米鳍片的制备超构全息图SEM图像。
• h 具有不同取向高纵横比(AR)二氧化钛(TiO₂)纳米鳍片的制备超构透镜SEM图像。
• i 具有不同尺寸高纵横比(AR)二氧化钛(TiO₂)纳米柱的制备超构透镜SEM图像,比例尺:600纳米(nm)。
• j 具有不同尺寸高纵横比(AR)二氧化钛(TiO₂)纳米渔网结构的制备超构透镜SEM图像。
• k 具有不同取向双层高纵横比(AR)二氧化钛(TiO₂)纳米鳍片的制备超构表面SEM图像。
• l 具有不同取向空腔双层铝(Al)纳米棒的制备超构透镜SEM图像,比例尺:300纳米(nm)。
• m 具有高纵横比(AR)光刻胶纳米鳍片的制备超构表面SEM图像。
• n 具有光刻胶光栅的制备超构表面SEM图像。
版权及来源:
• a 经许可转载自参考文献128,版权所有2017,施普林格·自然(Springer Nature)。
• b 经许可转载自参考文献130,版权所有2024,施普林格·自然(Springer Nature)。
• c 经许可转载自参考文献131,版权所有2018,施普林格·自然(Springer Nature)。
• d 经许可转载自参考文献132,版权所有2019,施普林格·自然(Springer Nature)。
• e 经许可转载自参考文献135,版权所有2021,美国科学促进会(American Association for the Advancement of Science, AAAS)。
• f 经许可转载自参考文献136,版权所有2023,国际光学工程学会(Society of Photo-Optical Instrumentation Engineers, SPIE)。
• g 经许可转载自参考文献137,版权所有2016,美国国家科学院(National Academy of Sciences, NAS)。
• h 经许可转载自参考文献30,版权所有2016,美国科学促进会(American Association for the Advancement of Science, AAAS)。
• i 经许可转载自参考文献138,版权所有2016,美国化学会(American Chemical Society, ACS)。
• j 经许可转载自参考文献139,版权所有2020,施普林格·自然(Springer Nature)。
• k 经许可转载自参考文献140,版权所有2025,施普林格·自然(Springer Nature)。
• l 经许可转载自参考文献141,版权所有2020,施普林格·自然(Springer Nature)。
• m 经许可转载自参考文献142,版权所有2020,美国化学会(American Chemical Society, ACS)。
• n 经许可转载自参考文献143,版权所有2023,中国激光出版社(Chinese Laser Press)。
电子束光刻(EBL)技术在超构表面制备中的应用及工艺细节
硬掩模层不仅是图形转移的介质,还能保护下方的基底材料。在蚀刻过程中,基底材料可能遭受物理或化学损伤,而添加一层或多层硬掩模层可有效减少这类损伤。
1. 基于硬掩模的可见光波段超构透镜制备
• Wang等人(参考文献131):制备了可见光波段宽带消色差超构透镜。工艺为:在蓝宝石衬底上通过MOCVD沉积800nm厚未掺杂GaN层→PECVD沉积400nm厚SiO₂层→旋涂并烘烤100nm厚EBR层后用EBL图形化→EBE沉积40nm厚Cr层(硬掩模)→剥离剩余EBR,RIE蚀刻SiO₂实现图形转移(SiO₂作为硬掩模)→ICP RIE蚀刻GaN形成纳米结构→去除剩余SiO₂,最终得到轮廓清晰的纳米鳍片及反转结构(图5c)。
• Lin等人(参考文献132):开发全色光场消色差相机,基于可捕捉光场信息的超构透镜阵列,制备工艺与参考文献131一致(图5d)。
• Fan等人(参考文献133):设计算法生成的超构透镜,可产生旁瓣抑制、焦深显著的光片,工艺同上。
• Wang等人(参考文献134):提出自上而下蚀刻法制备TiO₂纳米柱,其纵横比(AR)极高——柱高1.5μm,侧壁垂直度接近90°。
2. 非平面衬底上的EBL工艺与超构曲面制备
因电子束焦深有限,非平面衬底上的EBL工艺难度极大。Nikolov等人(参考文献135) 成功制备超构曲面(融合自由曲面光学与超构表面优势),工艺为:在环形衬底(凹面区域覆盖6mm直径圆孔)上通过EBE依次沉积120nm厚Ag层(底层)和75nm厚SiO₂层→在SiO₂层上旋涂EBR双层(60nm厚底层PMMA 495、80nm厚顶层PMMA 950)→采用焦区分裂法,EBL图形化EBR双层→EBE沉积Ag层形成纳米结构→剥离剩余PMMA。最终超构光栅基于Ag-SiO₂-Ag三明治结构,覆盖2×1.5mm超构曲面区域(图5e)。
3. 大面积超构表面的EBL制备(特征投影模式)
EBL可制备大面积超构表面,Zeitner等人(参考文献136) 利用特征投影(CP)EBL写入模式,高效制备大面积光学纳米结构(对重复单元超构表面优势显著)。在300mm直径Si晶圆上,通过CP-EBL制备280mm直径纳米压印母版,母版含超构光栅(由不同直径和间距的密集点阵列构成),最小特征尺寸100nm、间距200nm(图5f)。该技术显著提升写入速度(较传统方法高几个数量级),是可接受时间内高效制备大面积超构表面的唯一可行技术。
4. 高纵横比(AR)超构表面的制备(ALD辅助与创新工艺)
传统自上而下干法蚀刻难以制备高AR纳米结构,且易导致侧壁粗糙度增加。
• Capasso团队(参考文献137):基于原子层沉积(ALD)技术制备高AR超构表面(ALD可精准控制膜厚、实现均匀覆盖)。工艺为:在熔融石英衬底上依次旋涂并烘烤附着力促进层和600nm厚EBR层→EBE沉积10nm厚Cr膜(抑制写入时的充电效应)→EBL图形化EBR(定义纳米结构几何特征)→ALD沉积TiO₂膜至完全填充图形(初始沉积可 conformal 覆盖EBR侧壁、顶部及暴露衬底,膜厚需不小于间隙最大宽度的一半,建议超最小要求以避免空隙)→RIE蚀刻TiO₂至暴露底层EBR→去除剩余EBR。所制备超构全息图在480nm、532nm、660nm波长下效率分别达82%、81%、78%(图5g)。
• Capasso团队(参考文献30):采用上述工艺制备3个可见光波段、数值孔径(NA)0.8的高AR超构透镜,获侧壁垂直度近90°的纳米结构(非干法蚀刻)。240mm直径、90mm焦距的透镜在405nm、532nm、660nm波长下聚焦效率分别为86%、73%、66%(图5h)。
• Capasso团队(参考文献138):同上工艺制备3个NA 0.6和3个NA 0.85的可见光超构透镜(图5i)。NA 0.6透镜在对应波长下效率30%、70%、90%;NA 0.85透镜效率33%、60%、60%,可将入射光聚焦至~0.64λ的光斑,实现超高分辨率成像。
• Ndao等人(参考文献139):通过上述工艺制备渔网结构消色差超构透镜(图5j),EBR定义纳米结构形状,使单元设计具备多自由度。
• Capasso团队(参考文献140):开发双层高AR超构表面制备新方法,可见光波段工作,由独立堆叠的自支撑TiO₂纳米鳍片构成(每层通过几何相位实现0-2π独立相位覆盖)。工艺大体同参考文献137,但需注意顶层电子束加工时底层抗蚀剂会暴露于弹道电子,需精选抗蚀剂与显影液:底层选ZEP520A(显影液邻二甲苯),顶层选PMMA(显影液MIBK/IPA 1:3或H₂O/IPA 1:3),实现顶层选择性显影且不影响底层,最终得到双层高AR TiO₂纳米鳍片(图5k)。
5. 无需蚀刻/剥离的EBL直接制备工艺
EBL可直接定义抗蚀剂形成纳米结构,避免蚀刻或剥离过程导致的结构损伤。
• Li等人(参考文献141):制备腔增强双层超构透镜(效率提升)。工艺为:在ITO涂层石英衬底上旋涂100nm厚PMMA层→EBL图形化PMMA→沉积30nm厚Al层,无需剥离步骤,避免结构波动(图5l)。
• Andrén等人(参考文献142):直接用曝光后的抗蚀剂构建超构表面,无需额外材料沉积、剥离或蚀刻(图5m)。
• Sin Tan等人(参考文献143):利用大面积超构表面开发经济型全介质多层防伪印刷工艺(基于SU-8光栅)。在Si衬底上旋涂并烘烤~650nm厚SU-8层→EBL图形化SU-8直接形成纳米结构→去除未图形化SU-8,11分钟内实现1mm²大面积印刷(抗蚀剂灵敏度高,特征尺寸~200nm)(图5n)。建议避免后烘烤,以减少残留层并防止热暴露导致的交联效应。
聚焦离子束(FIB)技术及其在超构器件制备中的应用
- 收藏