新设备推介:8英寸LPCVD-Poly Si(B301)
2025-03-28
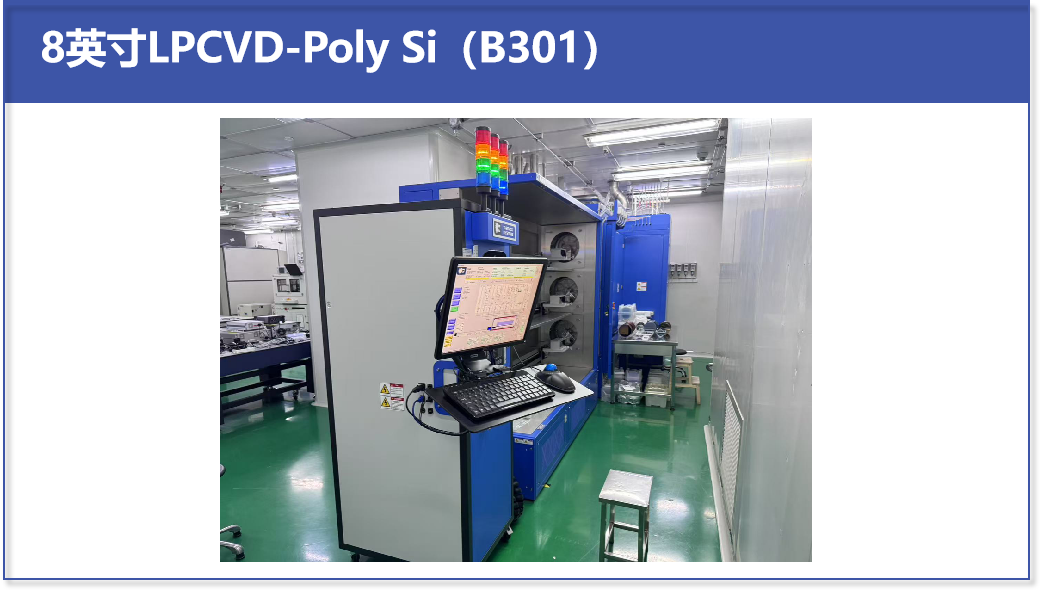
1、设备原理:
2、设备亮点:
3、主要用途:
LPCVD制备的Poly Si在微电子和微纳加工领域具有广泛的应用,可用于结构层、牺牲层、钝化层、掩膜层、绝缘层和阻挡层等。
▋▍技 术 指 标
1、升/降温速率:3℃/min-5℃/min
2、极限真空:小于5mTorr
3、工艺控压范围:100mTorr-800mTorr
4、设备工艺温度:500℃-850℃
5、工艺气体:SiH4、PH3、N2
6、样品尺寸:标准6、8英寸
▋▍工 艺 示 例
样品放置及薄膜应力测试结果如下所示


- 收藏




